台积电宣布3200平方毫米巨型芯片:整合封装12颗HBM
时间:2020-08-26 21:15:05
作者:重庆seo小潘
来源:
除了5nm、4nm、3nm、2nm工艺进展和规划,台积电近日还公布了不少新的芯片封装技术,毕竟随着高性能计算需求的与日俱增、半导体工艺的日益复杂,单靠升级制程工艺已经不能解决所有问题。 台积电的CoWoS-S晶圆级封装技术已经使用了很多年,大大突破了光刻掩膜
除了5nm、4nm、3nm、2nm工艺进展和规划,台积电近日还公布了不少新的芯片封装技术,毕竟随着高性能计算需求的与日俱增、半导体工艺的日益复杂,单靠升级制程工艺已经不能解决所有问题。
台积电的CoWoS-S晶圆级封装技术已经使用了很多年,大大突破了光刻掩膜尺寸的限制,芯片越做越大,内部封装的小芯片也越来越多。
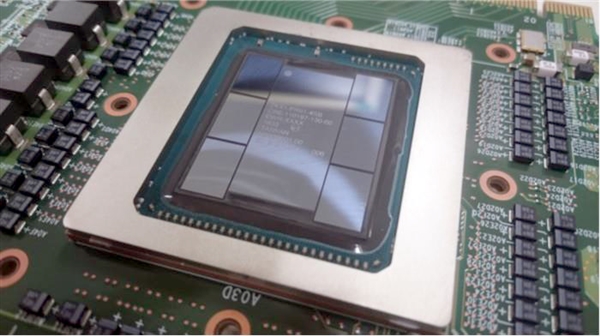
2016年的时候,台积电做到了1.5倍于掩模尺寸的规模,单芯片内部可封装4颗HBM高带宽内存芯片,去年达成2x尺寸、6颗HBM,并计划明年实现3x尺寸、8颗HBM。
根据台积电最新公布的规划,2023年的时候,他们将把芯片做到4倍于掩模尺寸的程度,内部可以封装多达12颗HBM,再加上主芯片就有13颗,而总面积估计可达惊人的3200平方毫米。
作为对比,NVIDIA安培架构的GA100核心面积为826平方毫米,7nm工艺,540亿晶体管,也不过它的大约四分之一。
HBM技术发展迅速,虽然还不确定2023年会是什么样子,但无论容量还是带宽都将超越很多人的想象,上百GB、TB/s应该都不是事儿。
目前最先进的三星HBM2e已经做到单颗12层堆叠,数据传输率3200MT/s,带宽至少4.92TB/s。



